測量儀的類型
膜厚計
分光干涉式膜厚計
向量測目標照射寬波長頻帶的光,對表面和背面反射的光的干涉強度光譜進行FFT分析,從而量測膜厚。用量測結果除以量測目標的折射率求出膜厚。
光源有SLD、LED、鹵素燈等,依據膜厚範圍、光點尺寸、速度、壽命等選擇。量測多層膜時,透過使各膜分界面上的反射光發生干涉,可以量測各膜厚。
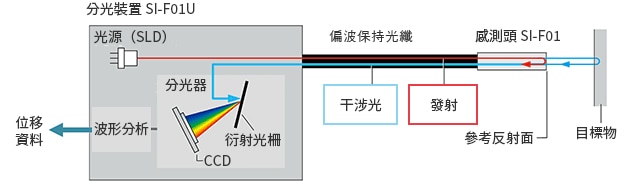
紅外線吸收式膜厚計
向量測目標照射紅外線,依據透過光(或反射光)的分光光譜量測特定波長的吸光度,換算為膜厚。依據各材料的「吸收光譜與膜厚的關係」,選擇不同膜厚下吸光度變化大的波長作為特定波長。
靜電容量式膜厚計
在與感測器相對的方向上固定導體面,透過量測將量測目標(絕緣體)放入兩者之間時的靜電容量,量測膜厚。很多情況下量測目標的介電常數不明,因此分別量測未放入任何物體時和放入已知厚度目標物時的靜電容量進行計算。
放射線式膜厚計(β射線式、X射線式)
向量測目標照射放射線,部分散亂至後方,該散亂射線量受到該物質的厚度以及電子編號的影響而有所不同。
厚度增加時,後方散亂量增加,因此比較底料和皮膜的後方散亂量,可以量測厚度。
底料和皮膜的原子編號差越大,量測精度越高。
另外,透過式中量測放射線的衰減程度,可以作為薄膜膜厚計使用。








