快速準確量測 IC(Integrated Circuit 集成電路)的方法
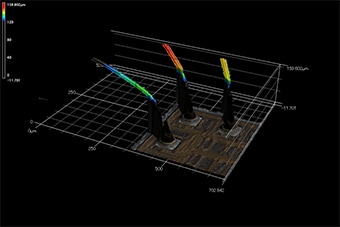
隨著第五代移動通信系統(5G)的普及,半導體器件的小型化和高集成化不斷進步,對產品檢查和分析的需求也越來越大。最新的“VK-X系列”除了可進行重複量測、在同一樣品中記錄多個部位並自動量測的教學批量分析外,還可通過製作範本進行OK/NG判斷。在此,我們介紹藉由雷射顯微鏡檢查案例多的BGA、打線接合、接觸探針等技術資訊和檢查用途案例。
IC封裝的代表類型
隨著IC集成度的提高,表面黏著型已成為主流。矩陣型(BGA 型)封裝用於高度集成的 IC。LSI 代表Large Scale Integration(大規模集成電路),但幾乎與 IC(Integrated Circuit 集成電路)同義使用。
插入型封裝
- SIP (Single Inline Package)
-
這是一種插入印刷電路板的封裝。一排導線從封裝的長邊延伸出來。

- DIP (Dual Inline Package)
-
這是一種插入印刷電路板的封裝。導線從封裝長邊的兩側向下延伸。

表面黏著型導線類型封裝
- SOP (Small Outline Package)
-
這是一種表面黏著型封裝,導線從封裝的兩側延展,尖端像鷗翼(Gull Wing)一樣向外展開。

- SOJ (Small Outline J-leaded package)
-
這是一種表面黏著型封裝,導線從封裝的兩側延展,尖端向內彎曲以固定封裝體。從側面看,導線呈“J”字形。

- QFP (Quad Flat Package)
-
這是一種表面黏著型封裝,導線從封裝的四個方向延展,尖端像鷗翼(Gull Wing)一樣向外展開。

- QFJ (Quad Flat J-leaded package)
-
這是一種表面黏著型封裝,導線從四個方向延展,尖端向內彎曲以固定封裝體。
從側面看,導線呈“J”字形。
表面黏著型無導線型的封裝
- SON (Small Outline Non-leaded package)
-
這是一種沒有導線,而是使用電極焊墊作為端子進行連接的表面黏著型封裝。SON 是一種用於低針腳數的2方向類型的封裝。

- QFN (Quad Flat Non-leaded package)
-
這是一種沒有導線,而是使用電極焊墊作為端子進行連接的表面黏著型封裝。QFN 是一種4方向類型的封裝。

表面黏著型矩陣類型的封裝
- BGA (Ball Grid Array)
-
通過在封裝底部以陣列形狀排列焊球形成端子。

- PGA (Pin Grid Array)
-
通過在封裝底部以陣列形狀排列針腳形成端子。

- LGA (Land Grid Array)
-
通過在封裝底部以陣列形狀排列由銅等製成的電極焊墊來形成端子。
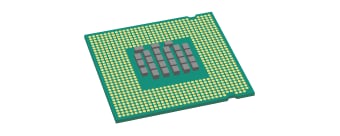
貼裝IC晶片的典型接合方法
- 打線接合
-
這是用金、鋁、銅等細線連接半導體晶片的電極部分和導線框或印刷電路板上導體的方法。

- 覆晶接合
-
這是一種將IC晶片直接連接到印刷電路板上的方法,稱為FCBGA(Flip Chip-BGA)。焊點形成在IC晶片的電極上並連接到印刷電路板上的電極。與打線接合相比,可以節省空間。

- A
- IC晶片
- B
- 倒裝(面朝下)
覆晶接合的焊點形成方法的種類
- 焊球搭配法
- 將預先形成的球形焊球放置在電極上,並通過回流焊形成焊點。與錫膏印刷法相比,可以使凸點更高,通過將焊球的尺寸控制為一定,可以抑制焊點高度的偏差。
- 錫膏印刷法
- 焊膏印刷在電極上,並通過回流焊形成焊點。更高的產量,但更難控制高度偏差。
- 鍍層法
- 焊錫焊點是通過電鍍形成的。可以形成細微的焊點,但產量低。
打線接合流程
-
金線穿過稱為瓷嘴的注射器狀圓柱體。用高壓點燃打線末端使其變圓,然後將該部分接合於要連接的電極。這稱為Ball Bonding(焊球接合)或1st Bonding(第一次接合)。接合是通過瓷嘴力、超聲波和來自接合階段的熱量來完成的。

-
當1st Bonding結束移動到2nd Bonding點時,接合線不斷送出,接合線在瓷嘴的移動下形成環路。

-
與導線電極的連接是通過用瓷嘴壓碎打線而不形成球來實現的。這種接合稱為Stitch Bonding(縫合接合)或2nd Bonding(第二次接合)。
-
關閉線夾並夾住金線後,提起瓷嘴以剪斷線材。

瓷嘴尖端部的名稱
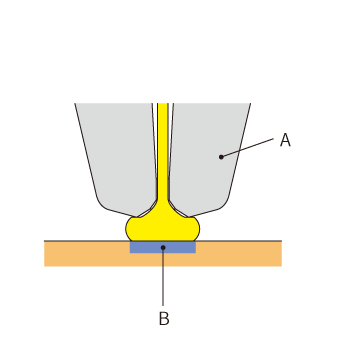
- A
- 瓷嘴
- B
- 接合部
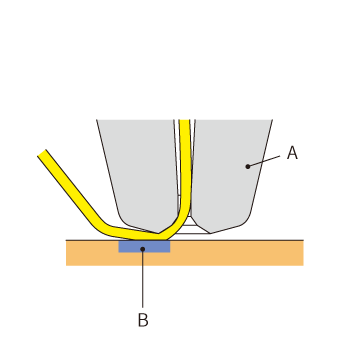
- A
- 瓷嘴
- B
- 接合部

- A
- 錐角
- B
- 面角
- C
- 倒角角度
- D
- 倒角直徑
- E
- 孔徑
- F
- 尖端直徑
打線接合檢查案例
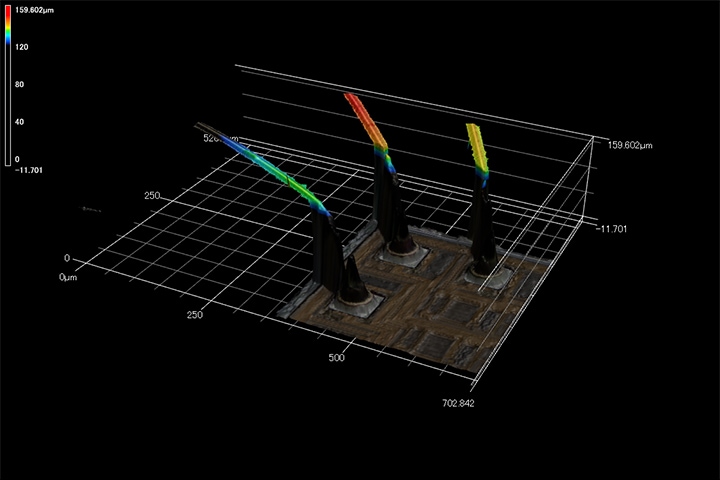

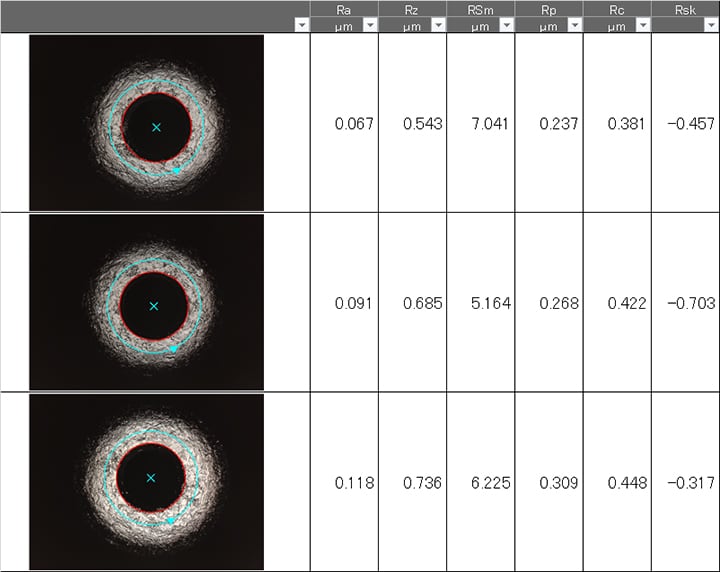
IC檢查案例
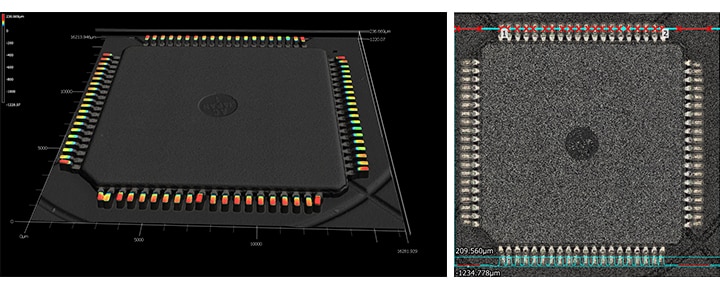
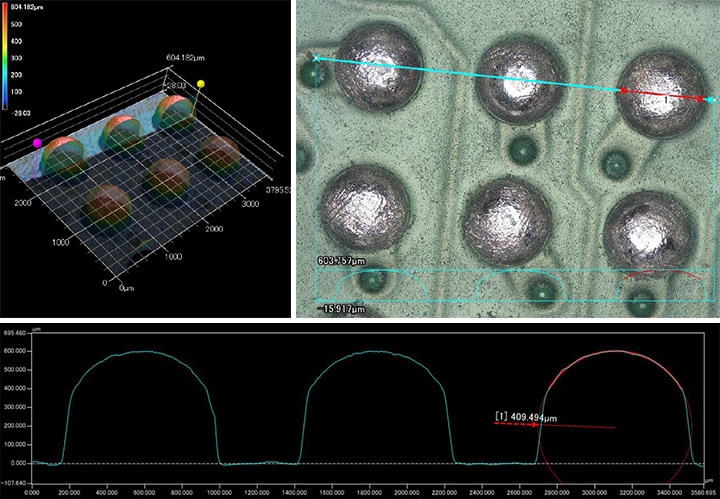



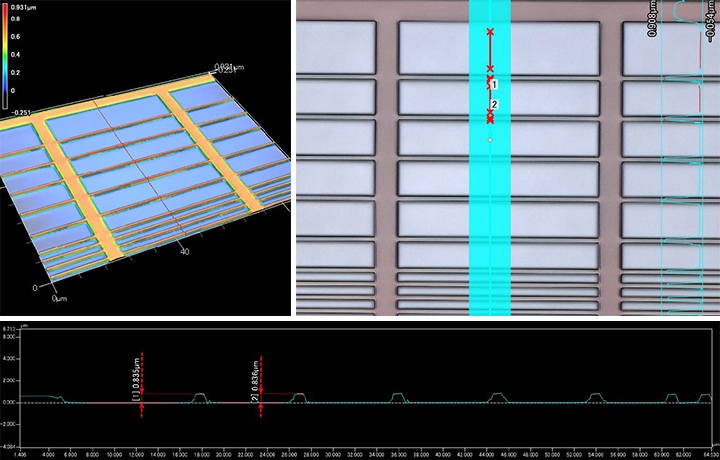



電氣檢查方法
本節介紹電子元件的典型電氣檢查方法。除了簡單的open(斷開)/short(短路),還可以通過電流,進行高頻量測等。
- 探針卡
-
該治具用於在 LSI(半導體集成電路)製造(前製程)的晶圓檢查製程中對矽晶圓上形成的 LSI 晶片進行電氣檢查。
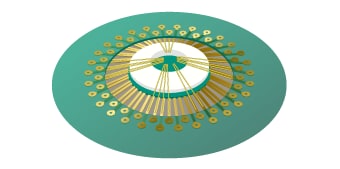
- 接觸探針
-
用於檢查各種電子元件的治具。檢查對象廣泛,包括半導體、液晶面板、原板、貼裝印刷電路板、連接器、電容器、傳感器等。

探針卡類型
- 垂直型探針卡
-
帶有塊的探針卡,探針垂直固定在印刷電路板上。
- 【優點】
- 探頭排列自由(方格狀,適合多次量測)
- 易於維護(可以從一根開始更換)
- 凹痕小
- 不損壞焊錫
- 【缺點】
- 價格偏高
- 不好對付鋁墊

- 懸臂式探針卡
-
將鎢等針直接固定在印刷電路板上的探針卡。
- 【優點】
- 價格便宜
- 間距比垂直型窄
- 好對付鋁墊
- 【缺點】
- 針腳佈局受到限制
- 維護困難(需要高度調整等修理)
- 凹痕大
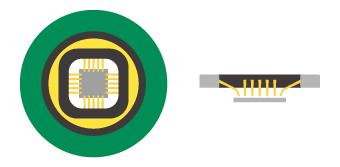
接觸探針結構和尖端形狀
由柱塞、筒體、彈簧構成,埋入樹脂製治具中使用。
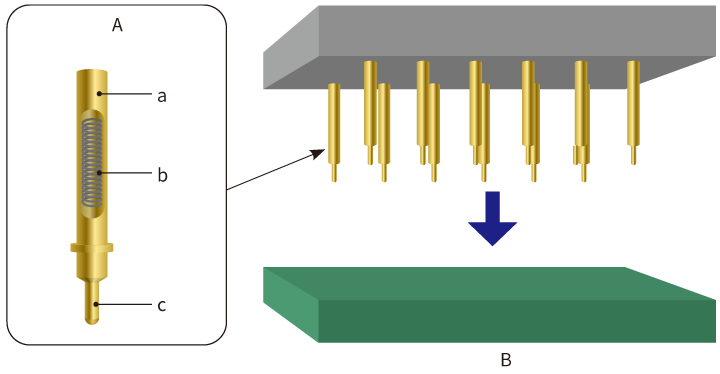
- A
- 接觸探針
- a
- 筒體
- b
- 彈簧
- c
- 柱塞
- B
- 檢查對象
- 半徑
-
當您不想損壞電極時使用,例如柔性印刷電路板。

- 針
-
主要用於印刷電路板的焊墊等。

- 平錐和倒錐
-
當您想進行表面接觸以免損壞電極時,使用平錐。接收端子時使用倒錐。
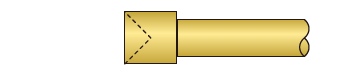
- 三角錐
-
用於印刷電路板的通孔等。

- 冠頂
-
當您想要進行多點接觸或當您想要接收貼裝部件的導線時使用。

接觸探針檢查案例




